
过去十年,苹果始终依赖“多层石墨片 + VC 均热板”的组合为 A 系列芯片降温。石墨片的面内导热系数可达 800–1100 W/m·K,具备轻薄、柔性等优势,几乎成为 100W 级旗舰手机的“标准答案”。
然而,供应链数据显示,A18 Pro 在持续 AI 算力场景下的封装功耗已冲至 24W,局部热点功率密度突破 300W/cm²。石墨片虽具高横向导热能力,但纵向导热仅 20–30 W/m·K,热量在芯片与均热板之间堆积,边际收益明显递减。随着功耗提升与机身厚度压缩,“热阻天花板”已触手可及——材料换代成为必然。

iPhone 17 Pro 首次采用“2.5D 玻璃中介层 + 双芯并排”的封装结构,将应用处理器与独立 AI 加速器集成在同一块 4.5 英寸玻璃转接板上,并整体倒装于高密度主板。
玻璃中介层厚度仅 100 µm、热导率仅 1–2 W/m·K,几乎成为“绝热层”;两颗芯片在 7 mm 间距内总功耗约 35W,热梯度超过 40 ℃。传统的石墨片 + VC 方案难以将热量快速传导至不锈钢中框,导致热节流提前触发。
行业数据显示,当单封装功耗超过 30W、厚度低于 0.4 mm 时,石墨片的横向导热优势被纵向热阻抵消,必须引入面内热导率 >1200 W/m·K、且厚度 <50 µm 的新型散热材料。
单晶金刚石的面内热导率高达 2000–2200 W/m·K,是铜的 5 倍、石墨片的 2 倍,同时具备 >10¹² Ω·cm 的高电阻率,可直接贴合芯片背面而无需额外绝缘层。
更重要的是,多晶金刚石可通过 MPCVD 技术在 6–8 英寸硅基板上沉积 30–100 µm 连续膜,翘曲度 <10 µm,完全满足 FCBGA 热压键合的平整度要求。
Amkor 的验证数据显示,在相同 35W 功耗条件下,使用 50 µm 金刚石膜替代“石墨片 + 0.2 mm 铜合金”后,热阻由 0.42 ℃/W 降至 0.18 ℃/W,芯片结温下降 12 ℃,AI 算力持续峰值提升约 8%。
苹果于 2024 年启动的 “Koa” 散热项目,正联合两家日系 MPCVD 设备厂,评估 4 英寸金刚石热沉在 iPhone 上的量产可行性。
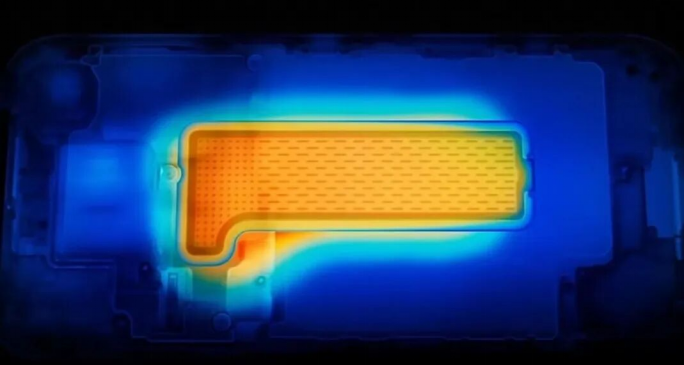
一年前,100 mm 多晶金刚石衬底价格仍高达 400 美元/片。而随着国机精工、宁波材料所等企业将 MPCVD 生长速率从 3 µm/h 提升至 7 µm/h,单片成本已降至约 180 美元,预计 2026 年有望跌破 100 美元。
苹果内部评估显示,当金刚石薄膜成本 ≤120 美元时,在 iPhone Pro 系列中替代石墨片 + VC 的物料成本增幅不足 3%,却可节省 0.3 mm 厚度,为电池扩容创造空间,ROI 转正。
供应链消息称,苹果已要求 2025 年第四季度完成“金刚石 + 玻璃中介层”的可靠性验证。若 2026 年量产良率可达 85% 以上,iPhone 18 Pro 将首次在 SoC 背面直接键合 25 µm 金刚石热沉,而 iPhone 17 Pro 则作为技术前奏,已在部分批次中采用“石墨片 + 局部金刚石贴片”的混合结构。
短期内,石墨片仍将在中低端机型中以“低成本导热垫”的形态继续存在。但在高端 AI 手机及 2.5D/3D 封装赛道上,当金刚石薄膜成本跌破 100 美元,其“极限热导率 + 电绝缘 + 晶圆级工艺兼容性”的综合优势将全面碾压传统方案。
iPhone 17 Pro 的散热革新,本质上是先进封装将“热管理”问题从系统层面下沉到材料层面。金刚石,正成为唯一能兼顾物理极限与消费电子量产纪律的解决方案。石墨片的退场,不是“会不会”,而是“从哪一款”开始。2025 年的试水,极可能成为 2026 年旗舰机散热材料全面换代的起点。
作为国内领先的金刚石材料供应商,晶沐光电专注于高热导多晶金刚石薄膜、晶圆级贴片及热界面材料的研发与量产,可供应 2-6 英寸金刚石膜,面内热导率可达 1800 W/m·K,翘曲度 <8 µm,兼容主流封装工艺。

